半導体デバイスに用いられるゲート酸化膜、層間絶縁膜、保護膜といった機能膜の膜厚制御は、デバイスの性能や信頼性を左右する重要な要素です。
近年では、デバイスの微細化とウェハの大口径化が進み、ウェハ面内におけるわずかな膜厚ばらつきであっても、特性変動や歩留まり低下につながる可能性がより高まっています。
そのため、プロセスの安定化による品質向上の観点から、ウェハ全面での膜厚ムラや局所的な異常を把握するための膜厚分布の取得に注目が集まっています。

半導体デバイスに用いられるゲート酸化膜、層間絶縁膜、保護膜といった機能膜の膜厚制御は、デバイスの性能や信頼性を左右する重要な要素です。
近年では、デバイスの微細化とウェハの大口径化が進み、ウェハ面内におけるわずかな膜厚ばらつきであっても、特性変動や歩留まり低下につながる可能性がより高まっています。
そのため、プロセスの安定化による品質向上の観点から、ウェハ全面での膜厚ムラや局所的な異常を把握するための膜厚分布の取得に注目が集まっています。

今回のデモでは、3台の特徴の異なるハイパースペクトルカメラと膜厚マップを生成できる解析ツールを用いて、SiO2膜の膜厚マップの作成・比較を行いました。
今回のデモでは、同一仕様のシリコンウェハを3枚用意しました。Si基板上に、膜厚800 nm ± 80 nmのSiO₂の酸化膜を形成したウェハです。
そして、そのうち1枚については、ウェハ表面の一部を研磨剤で擦り、酸化膜を局所的に除去することで膜厚が変化した領域を意図的に作製しました。
<シリコンウェハ>
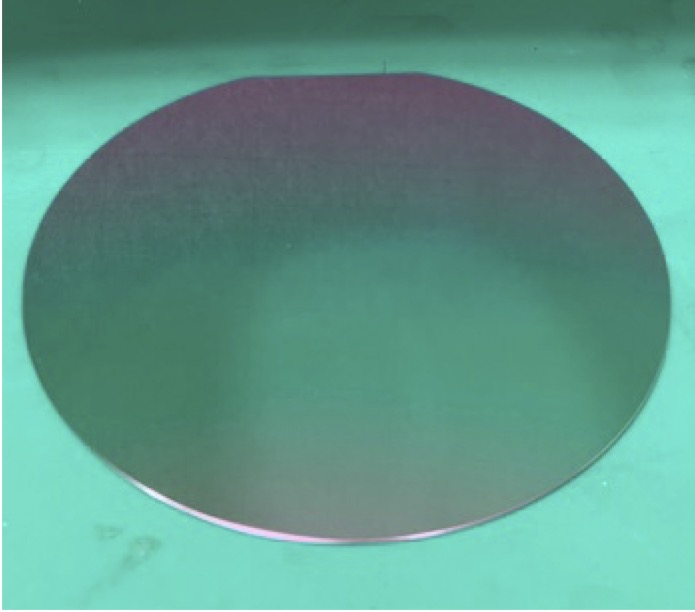
<シリコンウェハ(研磨)>

また、測定では、特徴の異なる3台のスペクトルカメラを用いて撮影を行い、FluxTrainer Proの膜厚マップ作成機能により各ピクセルの膜厚を算出しました。
これらにより、以下の点を確認することを目的としました。
現在、半導体ウェハの膜厚測定には、白色干渉膜厚計やエリプソメータといった、分光情報を用いた非接触・非破壊かつ高精度なポイント型測定装置が広く用いられています。これらの手法は単一点での測定精度に優れる一方、測定は基本的にポイント単位で行われるため、ウェハ全面の膜厚マップを作成するにはステージ走査による多点測定が必要となります。
その結果、測定時間の増大や測定点数の制約によって、膜厚ムラや、エッジ部に特有の膜厚変化を十分に捉えきれない問題が発生します。
このような問題に対して、2次元空間における分光情報を取得できるスペクトルカメラを用いることで、測定時間を大幅に短縮できるだけでなく、より高密度な空間情報に基づいて膜厚のムラやエッジ部の膜厚変化を視覚的に把握できます。
その結果、従来のポイント測定では見逃されがちであった「局所的な膜厚異常」や「プロセス起因の問題」を把握することが可能となります。

このように、スペクトルカメラによる2次元分光情報の取得は、膜厚マップ測定において、非常に有力なアプローチといえます。
スペクトルカメラを用いることで、ウェハ全面の2次元分光情報を一度に取得することが可能です。
ただし、スペクトルカメラはあくまで分光データを取得するための手段であり、分光データを正しく膜厚へ変換できなければ、2次元の膜厚マップを作成することはできません。
そのため、分光データを解析するソフトウェアの役割が重要です。
今回のデモでは、複雑な解析や専門的な調整を行うことなく、ハイパースペクトルデータから2次元の膜厚マップを生成できるFluxTrainer Pro を使用しました。
FluxTrainer Proは、ノーコードでさまざまなスペクトル解析を行うことができるスペクトル解析ツールです。
膜厚測定に関しては、Si や SiO₂ の波長依存屈折率(n, k)データをライブラリとして備えており、物理モデルに基づいた高精度な計算が可能です。
また、解析モードとして、干渉縞の周期から高速に膜厚を求める Peak-based Thickness Filter と、光学モデルをフィッティングする Fit-based Thickness Filterの2手法を選択でき、単層膜から多層膜まで用途に応じた評価が行えます。
さらに、膜厚マップの階調表示やピクセル単位のヒストグラム解析にも対応しており、面内ばらつきを定量的に可視化できます。

ケイエルブイではスペクトルカメラの選定から測定環境の構築、解析ソフトウェアの導入、さらには運用サポートまでを一貫してご提案します。
国内No.1の取り扱い数を誇る11社のスペクトルカメラをラインナップから最適な機種選定し、光源、ステージ、周辺機器、スペクトル解析ツール、SDKを含めたトータルソリューションをご提供します。加えて、専門家のアドバイスなど、導入後も安心して活用いただけるサポート体制を整えています。
今回のデモの手順を以下に紹介します。
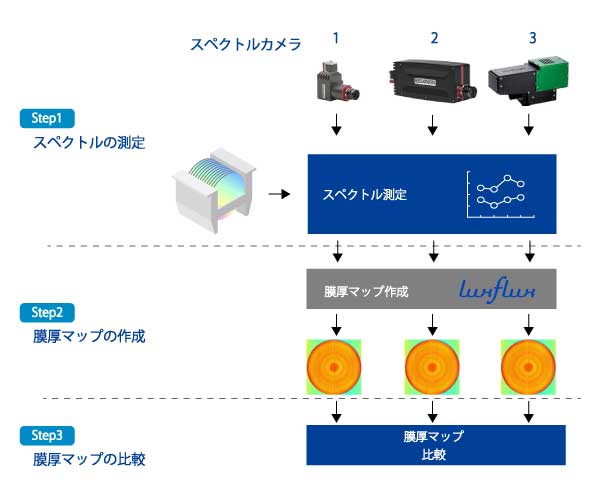
スペクトルカメラ(Resonon社のPika L、XC2、NEO社のHyspex Balder V-1024)を使用して、反射の2次元スペクトルを取得。
Fulx Trainer PROで膜厚マップを作成。
Pika L、XC2、Balderで算出した膜厚マップを比較。
分光干渉を用いた膜厚測定では、取得した分光スペクトルが、測定可能な膜厚のレンジや精度に影響するため、測定したい膜の種類や膜厚レンジ、さらには膜厚マップを通して何がしたいのかといった目的に応じて、適切なスペクトルカメラを選択する必要があります。
特に重要となるのが、[1]波長範囲、[2]波長分解能、[3]空間分解能の3つの観点です。
分光干渉法による膜厚測定では、使用する波長範囲によって測定可能な膜厚レンジ(特に薄膜側)が決まります。
膜厚が薄くなるとスペクトルの干渉の周波数が低くなり、観測できる波長範囲内に十分な干渉が現れなくなるため、膜厚を安定して算出することが難しくなります。
一方、膜が厚くなるほどスペクトル中の干渉の周波数が高くなり、干渉縞の間隔が狭くなります。
特に短波長側では干渉縞の間隔がさらに狭くなる傾向があるため、厚膜の測定では干渉縞の間隔が比較的広くなる長波長側の方が有利となります。
スペクトルカメラは、大きくSiセンサーを用いた400–1000nm帯と、InGaAsセンサーを用いた1000–2500nm帯に分かれます。
400–1000nm帯では膜厚は数十nm~十数µm程度、1000–2500nm帯では数µm~数十µm程度が一般的な目安となります。
波長範囲が主におおよその膜厚レンジ(主に下限)を決めるのに対し、波長分解能は膜厚算出の精度および膜厚レンジの上限を左右する重要な要素です。
膜厚が厚くなるほど干渉の周波数が高くなり、スペクトル上でより細かくなります。
波長分解能が不十分な場合、これらの縞を十分に分離できず、ピークや谷が潰れてしまいます。その結果、膜厚算出誤差が増大し、一定以上の厚みが解析困難になります。
一般に分解能が高いほど有利ですが、装置コストや測定速度などとのバランスを考慮し、目的とする膜厚レンジに適した仕様を選定することが重要です。
空間分解能とフレームレートで分光情報の取得ポイントの細かさが決まるため、膜厚マップにおける面内分布がどの程度詳細に可視化できるかの重要な要素になります。
細かい分光情報を取得できたほうが、局所的な膜厚ムラなどを捉えることが可能ですが、データが大きくなる、カメラサイズが大きくなる、コストが高くなるなどのデメリットがあります。また、視野(撮影する領域)が広いほど、測定点のポイントが離れるので、バランスを考慮することが重要です。
目的や予算に応じたスペクトルカメラや測定方法の選択が、結果を大きく左右する重要な要素になります。
スペクトルカメラ選びは世界中のスペクトルカメラを取り扱うケイエルブイに お問い合わせください。
今回のデモでは、800nm程度のSiO2膜を対象とするため、波長は、400-1000nm帯のものを選択しました。波長分解能、空間分解能、フレームレートに関しては、以下の3台の特徴の異なるスペクトルカメラを使用し、それぞれで膜厚測定を行いました。

Resonon社のPika Lは、400–1000 nmをカバーするコストパフォーマンスのバランスに優れたモデルです。
最大249 fpsのフレームレートと900画素の空間分解能を備えつつ軽量・コンパクトな設計のため、装置への組み込みがしやすい点が特徴です。

Resonon社のPika
XC2は、1600画素という高い空間分解能を特徴とする高解像度のハイパースペクトルカメラです。
細かなスペクトル情報が求められる検査・分析用途に適しています。

HySpexのBaldurシリーズは産業向けに開発された高速撮影が可能なライン型のスペクトルカメラです。
シリーズ内で最も高い性能を誇るモデルである「V-1024」は、1024画素の空間分解能と1000fpsの高速撮影を誇ります。
| 項目 | Pika L | Pika XC | Baldur V-1024 |
|---|---|---|---|
| 波長範囲 | 400–1000 nm | 400–1000 nm | 400–1000 nm |
| 波長分解能 | 281 | 447 | 88 |
| 最大フレームレート | 249 fps | 165 fps | 1000 fps |
| 空間分解能 | 900 画素 | 1600 画素 | 1024 画素 |
| 寸法 | 115 × 104 × 66 mm | 265 × 106 × 75 mm | 316 × 105 × 153 mm |
| 重量 | 0.64 kg | 2.51 kg | 4.2 kg |
分光干渉法による膜厚測定では、カメラや解析手法だけでなく、測定環境の構成が測定精度を大きく左右します。本測定では、斜入射による反射測定系を採用しました。
いくつかのポイントについて紹介します。

斜入射条件では、試料に対する入射角(光源側)と反射角(カメラ側)を一致させる必要があります。
これは、干渉情報を正しく取得するために、ウェハ表面で反射した直接光を正確に捉える必要があるためです。
また、入射角が設計値からわずかにずれるだけでも、膜内部における実効的な光路長が変化し、干渉縞の位相に誤差が生じます。
そのため、高精度な膜厚測定を実現するためには、光源・カメラ・ウェハの位置関係を安定して維持することが不可欠です。
ラインスキャン方式で、試料をステージで走査することで2次元の分光データを構築します。そのため、ステージの走査の安定性(振動のコントロール)は、膜厚マップの品質に直接影響します。
求められる膜厚精度に応じて、十分な剛性と安定性を備えたステージを選定することが重要です。
光源にはハロゲンのライン光源を使用しました。ハロゲン光源は可視から近赤外にかけて広帯域で安定したスペクトルを持つため、分光干渉測定に適した光源です。
本測定で使用したラインスキャンタイプのスペクトルカメラは、「空間1次元 x 波長方向」の分光情報を取得する構造であるため、ライン状に均一な照明を与えるライン光源との相性が非常に良好です。
このように、膜厚の干渉測定において取得するスペクトルの安定性が信頼性の高い膜厚マップを作成するための基盤となります。
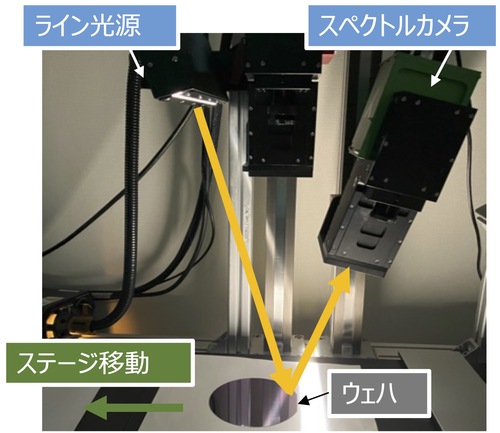
3機種(Pika L / Pika XC2 / Baldur)のスペクトルカメラで測定したスペクトルを以下に示します。
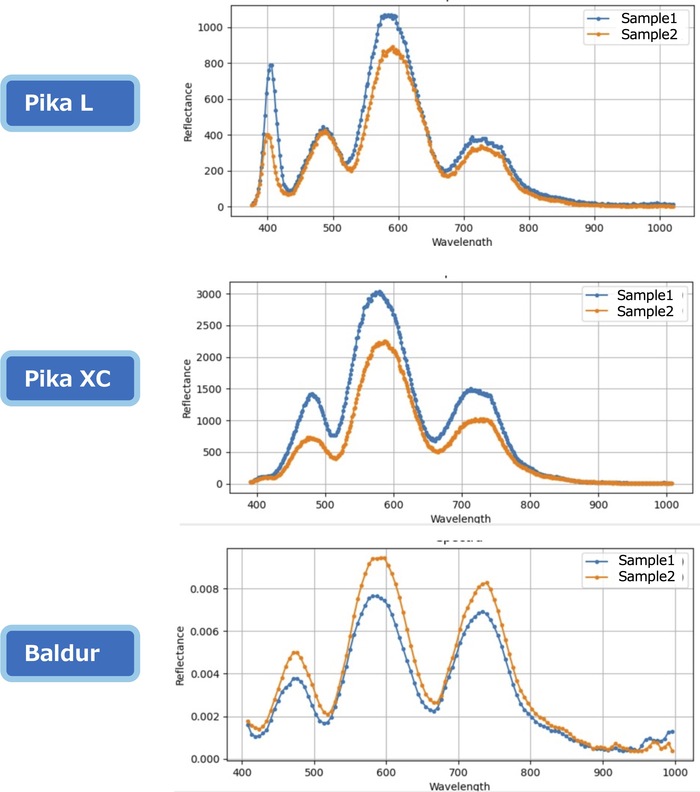
取得したスペクトルデータにおいてSiO₂膜による干渉(スペクトルの周期)を確認することができていることがわかります。
Pika L、Pika XC、Baldurの3機種はいずれも波長範囲は400–1000 nmで共通ですが、波長分解能(バンド数)に大きな違いがあります。Pika XCは447バンド、Pika Lは281バンド、Baldurは88バンドです。
Peak-based解析では、反射スペクトル中の干渉ピークの間隔を正確に求めることが重要です。
今回対象とした約800 nmのSiO₂膜では、可視域での干渉周期はおよそ50〜80 nm程度となります。
400–1000 nmを最も波長分解能の低いBaldurの88バンドで分割した場合の波長間隔は約7 nmで、1周期あたり十分なサンプリング点数を確保できます。
そのため、すべてのカメラで安定してピークを捉えることができていると言えます。
ただし、膜厚が数µm以上になると干渉周期はさらに短くなり、10〜20 nm程度まで狭まります。この領域では、88バンド構成ではピーク分離が難しくなる可能性があります。
より厚膜や高精度評価を行う場合には、高い波長分解能を持つPika LやPika XCが有利です。
また、Sample1とSample2の比較においては、どのスペクトルカメラでも、Sample2におけるスペクトルの干渉の頂点間隔がSample1のそれに対して狭くなっており、膜厚が厚いことがわかります。
取得したスペクトル情報をもとに、FluxTrainer Proを使用して膜厚のマップを作成しました。
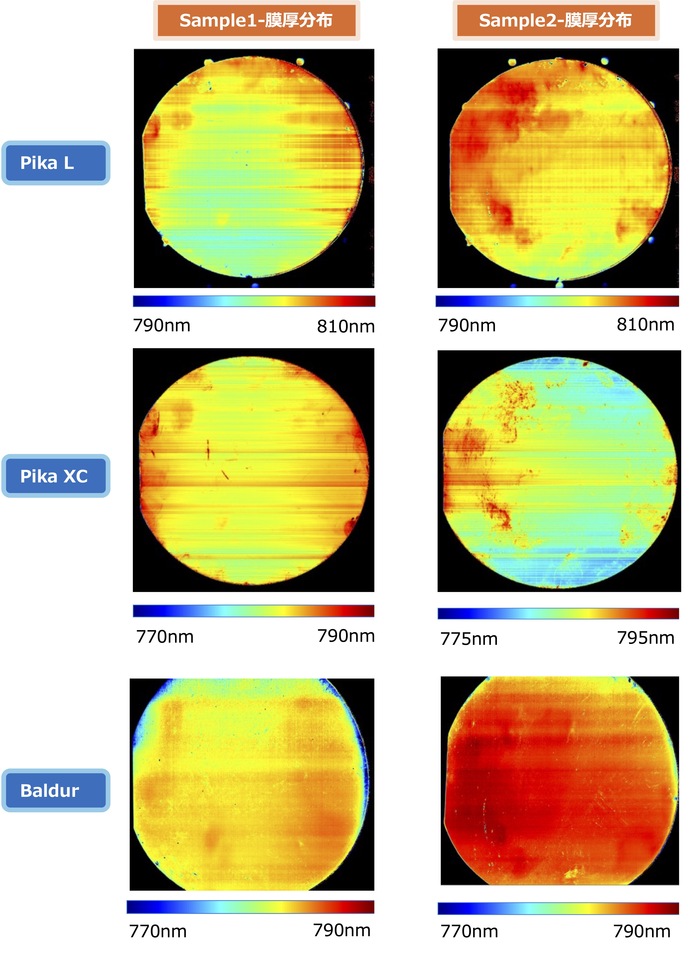
いずれの機種で作成した膜厚マップも期待値である720~880 nm の範囲でウェハ全面の膜厚分布を可視化することができています。
空間分解能の違いに注目すると、1600画素のPika XCではより細かなムラや局所構造が明瞭に表現され、1024画素のBaldur、900画素のPika Lでは全体傾向を把握できる結果となりました。
より微細な膜厚ムラやパターン評価を行う場合には、高い空間分解能が有利になることがわかります。
さらに、フレームレートにも違いがあります。ただし、精度と測定スピードとのトレードオフなので、低いフレームレートでも時間をかければ詳細な画像を取得することが可能です。
Sample1とSample2を比較すると、Sample1は比較的均一な膜厚分布を示しているのに対し、Sample2では面内に明確なムラや局所的な膜厚変化があることが直感的にわかります。
また、スペクトルの干渉の頂点間隔からもわかっていた通り、Sample2の方が膜厚が厚いことがわかります。
最後に、研磨処理を施した Sample3 について、スペクトルと膜厚マップを以下に示します。

スペクトルに関して、Sample3の通常箇所と研磨箇所で干渉のピークの位置が異なっていることがわかります。
これは、研磨によって酸化膜が薄くなった箇所の干渉条件が変化したためと考えられます。
さらに、膜厚マップを確認すると、中央下付近に「膜厚の異なる箇所」があることがわかります。
この時、研磨によって薄くなった膜の範囲や、領域について視覚的に確認することができます。
今回のデモでは、800 nm程度のSiO₂膜を形成したシリコンウェハを対象に、3台のスペクトルカメラとFluxTrainer Proを用いて膜厚マップの作成・比較を行いました。
スペクトル測定結果から、いずれのスペクトルカメラにおいてもSiO₂膜による干渉縞を明瞭に確認することができました。
次に、膜厚マップの作成・比較では、3機種ともウェハ全面の膜厚分布を可視化できる一方で、空間分解能の違いにより面内ムラや局所構造の表現力に差が現れました。
高空間分解能モデルでは、より微細な膜厚ばらつきの把握が可能であり、目的に応じた機種選定が必要です。
最後に、意図的に酸化膜を除去したウェハでは、スペクトルカメラを用いた2次元分光測定が、ウェハ面内の局所異常やプロセス起因の膜厚変動を可視化するイメージを取得することができました。
分光干渉を用いた膜厚マップ測定では、「波長範囲」、「波長分解能」、「空間分解能・フレームレート」などのカメラ仕様の各要素が測定結果に直結します。
よって、膜の種類・測定膜厚レンジ・必要精度・評価目的を明確にしたうえで、最適なスペクトルカメラを選択し、測定環境を整えることが、必要な膜厚マップ取得の鍵となります。
スペクトルカメラと解析ツールを組み合わせた膜厚測定のトータルソリューションに関するご相談がある方は、以下お問合せから、ケイエルブイにご連絡ください。
お問い合わせ